|
|

 |
|
Межотраслевая Интернет-система поиска и синтеза физических принципов действия преобразователей энергии
|
Общий каталог эффектов
| Ионное травление |
 |
Ионное травление
Описание
Ионное травление - удаление вещества с поверхности твердого тела в результате ионной бомбардировки. Ионное травление позволяет выявить структуру поверхности, создать необходимую структуру рельефа с очень высоким пространственным разрешением, а также очистить поверхность от нежелательных примесей.
В технологии электронных приборов ионное травление используется в основном для очистки поверхности подложки (мишени), а также для получения тонких плёнок путём осаждения на подложку распылённого вещества мишени. Для ионного травления, как правило, используются ионы инертных газов (Не, Ne , Аг , Кг, Хе) с энергией 0,1—10 кэВ. Наиболее эффективно процесс протекает при бомбардировке ионами с энергией 0,1—0,5 кэВ. При этом глубина проникновения ионов в материал ограничивается несколькими атомными слоями, что создает наиболее благоприятные условия для передачи атомам энергии, достаточной для их вылета с бомбардируемой поверхности.
Интенсивность ионного травления, характеризуется коэффициентом распыления, который определяется как отношение числа выбитых атомов материала к числу падающих на него ионов. Коэффициент распыления зависит от энергии, угла падения, массы и атомного номера бомбардирующих ионов, а также от плотности, массы, атомного номера и энергии поверхностной связи атомов распыляемого материала. Так, наибольшее значение коэффициента распыления атомов Ag, Si, Mo при бомбардировке их ионами Аг составляет соответственно 12; 7 и 2 (атомов на ион).
Селективное травление основано на различном значении коэффицентов распыления для разных атомов. При правильном подборе метода травления оно позволяет удалить с поверхности нежелательные атомы (примеси), почти не разрушая слои нормальных атомов (Рис. 1).
Селективное ионное травление.
Рис. 1.
Распылается материал я основном в виде отдельных нейтральных атомов, средняя энергия которых составляет 3—5 эВ. Количество распылённых конгломератов атомов (кластеров) незначительно (несколько процентов); в небольших количествах (ок. 1%) в-во мишени распыляется в виде ионов.
Способы ионного травления подразделяются на ионно-плазменные и ионно-лучевые.
При ионно-плазменном травлении обрабатываемая деталь размещается в непосредственной близости от зоны действия плазмы; такой способ позволяет обрабатывать большие площади (в несколько дм2 и более) с достаточно высокой равномерностью и высокой плотностью ионного тока. Однако при этом давление рабочего газа (обычно аргона) вблизи обрабатываемой детали довольно велико (свыше 1 Па), что приводит к обратной диффузии распыляемых частиц и уменьшению скорости травления. Иногда также приходится учитывать вредное рентгеновское воздействие плазмы не деталь. Кроме того, при таком способе нельзя регулировать углы падения ионов, что необходимо для получения эаденнои формы краёв углублений при воспроизведении мелкого рисунка не поверхности детали.
При ионно-лучевом травлении плазма и обрабатываемая деталь пространственно разделены в рабочей камере; травление осуществляется в вакууме выделенным из плазмы, ускоренным и сфокусированным ионным пучком (лучом). Преимущество этого способа травления перед ионно-плазменным состоит в возможности изменения угла падения ионов на поверхность обрабатываемой детали и в отсутствии возврата распыленных частиц. Точная регулировка направления ионного пучка позволяет осуществить прецизионную размерную обработку детали; при этом скорость травления участков в направлении, перпендикулярном к поверхности детали, в несколько раз превышает скорость травления вдоль поверхности детали, в результате чего уменьшается размытость границ рисунка.
Использование при ионном травлении инертного газа (аргона) в качестве рабочей среды обусловливает физический харектер взаимодействия ионов с деталью. Подобная обработка носит обычно слабоизбирательный характер: с поверхности детали удаляются практически любые материалы, а скорость травления отдельных участков изменяется лишь с учётом локальных значений коэффициента распыления. Однако в ряде случаев возникает необходимость удалить с поверхности детали часть плёнки, не повредив нижние слои. Это достигается использованием вместо аргона (или добавлением к нему) химически активных газов или их смесей.
Процессы, в которых наряду с физическим используется химический механизм травления, называются ионным реактивным и ионно-химическим травлением. Введение в плазму различных реактивных газов позволяет резко повысить скорость и избирательность травления. Указанные процессы обеспечивают высокую разрешающую способность, возможность последовательного выполнения в одной реакционной камере нескольких операций избирательного удаления, возможность полной или частичной автоматизации технологического процесса.
Ионное травление связано с разрыхлением и разрушением поверхностных слоев. Присутствие в рабочем газе реактивной добавки ускоряет травление, но структурные дефекты на поверхности сохраняются и по окончании процесса. Поэтому если такие дефекты нежелательны (из-за уменьшения электрической прочности тонких плёнок диэлектриков, образования поверхностных состояний, ускорения диффузии примесных атомов в тонких слоях и т п.), применяется плаэмохимическое травление в среде галоген-содержащих газов, которое отличается от ионно-химического травления меньшей энергией ионов и, соответственно, преобладанием химического механизма обработки (за счёт воздействия нейтральных химически активных частиц - радикалов). Концентрация структурных дефектов при этом заметно уменьшается.
Важное преимущество ионного травления перед жидкостным заключается в существенно меньшем потреблении реагентов, а также в возможности прецизионной размерной обработки изделии и полной автоматизации всего технологического процесса.
Ключевые слова
Области техники и экономики
Применение эффекта
Ионное травление, использующее в основном физический (в противовес химическому) механизм воздействия ионов плазмы на обрабатываемую деталь, применяется при очистке деталей из металлов, диэлектриков и полупроводников от оксидных слоев (плёнок), при изготовлении элементов из химически стойких покрытий, при создании элементов на химически нестойких поверхностях и получении высокоточных систем с субмикронными размерами элементов, например, в сочетании с электронной литографией.
Ионная обработка позволяет создать трехмерный рельеф на поверхности при создании деталей оптических систем, требующих высокого пространственного разрешения. Элементы рельефа будут иметь вертикальные границы и заданную высоту. К ним относятся элементы интегральной оптики, фазосдвигающие системы, фазовые фильтры и синтезированные голографические элементы.
Применение ионного травленя в создании оптических систем включает также ионную полировку, т.е. удаление дефектного слоя с поверхности оптического элемента, ионную и ионно-химическую асферизацию - метод, позволяющий получать и использовать при конструировании оптических систем новый класс высокоточных асферических поверхностей высших порядков; ионную ретушь - метод, который в сочетании с интерферометрическим контролем и расчетом профиля волновых фронтов на ЭВМ явился эффективным средством улучшения качества оптических систем.
Реализации эффекта
Устройство для ионного травления по методу "диодного распыления" представляет собой вакуумную камеру (заполняемую после откачки инертным газом, например, Ar, до давления 5—15 Па) с двумя электродами — катодом и анодом, отстоящими друг от друга на расстояние 4—5 см. Обычно катодом служит распыляемая мишень, а роль анода выполняет металлическая пластина (держатель подложки) с подложками, подготовленными для осаждения распыляемого вещества мишени. При подаче на катод (мишень) отрицательного (относительно анода) напряжения 4—5 кВ зажигается аномальный тлеющий разряд, и в результате возникает поток ионов, бомбардирующих мишень.
В установках для ионного травления «со смещением» держатель подложки не является анодом, а сам находится под отрицательным потенциалом (100—200 В) относительно анода, что вызывает ионную бомбардировку осаждаемых плёнок на подложках, удаляющую с их поверхности атомы и молекулы примесей.
Для уменьшения рабочего давления (до 10-2 Па) и повышения эффективности ионизации газа часто используют вспомогательный низковольтный дуговой резряд — источник ионизирующих электронов, который образуется между вспомогательным катодом и анодом. Такой способ называют «триодным» распылением.
Наибольшая эффективность ионного распыления достигается с применением магнитного поля, увеличивающего длину пробега эл-нов и, следовательно, степень ионизации рабочего газа, позволяя снизить давление в камере и увеличить мощность разряда. Этот способ распыления наиболее удачно реализуется в магнетронных распылительных системах. Магнетронное распыление обеспечивает скорость осаждения плёнок до 10—30 нм/с и создаёт возможность нанесения плёнок любых материалов, в т. ч. диэлектриков, с высокой степенью воспроизводимости, что обусловило широкое применение этого метода в производстве изделий электронной техники.
Установка для ионного травления.
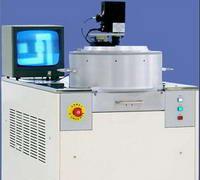
Рис. 1.
Литература
 1. Черезова Л.А. Ионно-лучевые методы в оптической технологии: Учебное пособие. - СПб: СПбГУ ИТМО, 2007.
1. Черезова Л.А. Ионно-лучевые методы в оптической технологии: Учебное пособие. - СПб: СПбГУ ИТМО, 2007.
 2. Ивановский Г.Ф., Петров В.И. Ионно-плазменная обработка материалов. М.: Радио и связь. 1986
2. Ивановский Г.Ф., Петров В.И. Ионно-плазменная обработка материалов. М.: Радио и связь. 1986


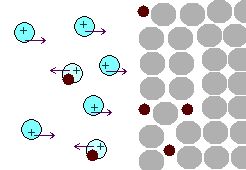
 Технологии производства печатных плат и печатного монтажа
Технологии производства печатных плат и печатного монтажа Молекулярная электроника
Молекулярная электроника Оптоэлектронная техника
Оптоэлектронная техника Полупроводниковые приборы и микроэлектроника
Полупроводниковые приборы и микроэлектроника Производство материалов для электроники и радиотехники
Производство материалов для электроники и радиотехники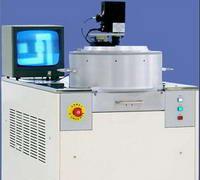
![]() 1. Черезова Л.А. Ионно-лучевые методы в оптической технологии: Учебное пособие. - СПб: СПбГУ ИТМО, 2007.
1. Черезова Л.А. Ионно-лучевые методы в оптической технологии: Учебное пособие. - СПб: СПбГУ ИТМО, 2007.
![]() 2. Ивановский Г.Ф., Петров В.И. Ионно-плазменная обработка материалов. М.: Радио и связь. 1986
2. Ивановский Г.Ф., Петров В.И. Ионно-плазменная обработка материалов. М.: Радио и связь. 1986